模糊参数变5nm!EUV缺陷飙升500倍!芯片良率悬了

半导体产业正持续推动微芯片向更小尺寸发展,极紫外(EUV)光刻技术作为2020年代以来先进芯片制造的核心工艺,其重要性不言而喻。然而,随着芯片特征尺寸不断逼近物理极限,生产过程中遇到的挑战也日益复杂。其中,由次级电子噪声和光刻胶模糊效应引发的随机缺陷(Stochastic Defects),已成为影响芯片良率和成本的关键因素。这类深层次的技术问题,正促使行业将关注点从传统的光学设计转向材料科学和微观物理层面。对于国内从事跨境电商、高科技供应链及相关产业的同仁而言,理解这些前沿技术动态,对于把握全球半导体产业格局、预判市场趋势具有重要的参考价值。
在EUV光刻工艺中,光子吸收过程具有典型的分割或稀疏泊松分布特征。每个被吸收的EUV光子都会释放出一定数量的电子,这些电子的数量通常被认为遵循一个整数范围内的均匀分布。当考虑电子散射效应时,由此产生的有效“模糊”效应会用一个以模糊尺度参数为特征的平滑轮廓,取代原始的、充满噪声的光子吸收轮廓。然而,这仅仅更新了每个“像素”的平均电子数量。这里的“像素”是指光刻胶分子的尺寸,对于化学放大抗蚀剂(CAR)可能在2纳米×2纳米左右,而对于金属氧化物抗蚀剂(MOR)则可能在1纳米×1纳米。业界通常会应用累积分布函数(CDF)来预测像素错误地高于或低于打印阈值的概率。这个CDF计算考虑了像素中模糊的平均电子数量以及电子数量的噪声。为了估算给定尺寸缺陷在特定位置的概率,研究人员通常会计算缺陷区域内像素这些概率的乘积。由此可见,较大缺陷(包含更多像素)的发生概率通常远低于较小缺陷。这一点在后续考量缺陷概率与间距的依赖关系时,显得尤为重要。
光刻胶模糊的重要性:对比度的降低
光刻胶模糊本质上是指光刻胶对光照的响应过程中,导致对比度相对于初始光学图像下降的现象。化学放大抗蚀剂(CAR)已知会因酸扩散而产生模糊效应,而EUV光刻胶则会因EUV光子吸收所释放的电子而产生模糊。酸模糊函数通常呈现高斯形状;它通过与预模糊图像进行卷积,形成后模糊图像。电子模糊的影响也以类似的方式通过卷积处理解决,但其形状实际上是两个函数的差,这使得零距离处的概率密度为零,但在合理的非零距离处具有峰值概率密度。其中一个函数(“内部”函数)具有较短的指数衰减长度,有助于设定峰值概率距离,而另一个函数(“外部”函数)具有较长的指数衰减长度,定义了一个长程尾部,与实验确定的电子衰减长度相对应。
对比度的降低意味着所有数值都更接近平均值。电子模糊实际上包含了电子在能量从光电子能量降至接近零的过程中传播的距离。虽然在给定能量下,电子的平均自由程可能在1纳米量级,但最终的电子模糊尾部衰减长度很容易超过这个值。这两种形式的模糊都会在一定程度上降低对比度。例如,标准偏差为s的高斯形状与间距为p的正弦波卷积,会导致对比度降低因子为exp(-2*[pis/p]^2);而标度参数为b的指数形状与相同的正弦波卷积,会导致对比度降低因子为1/(1+[2pi*b/p]^2)。当取两个指数或高斯函数的差时,结果必须除以这些函数相对权重的差,以重新归一化结果。对比度降低会使所有像素电子数(或酸数)值更接近平均值。因此,随着对比度进一步降低,累积分布函数(CDF)计算将使像素概率更接近50%。反之,如果对比度有所改善,远离特征边缘的像素的概率将从50%进一步降低。
更新后的光刻胶模糊代表性模型
深入查阅行业文献,可以发现一些关于EUV光刻胶模糊形状的有效信息。例如,基于聚甲基丙烯酸甲酯(PMMA)的EUV光刻胶模型的电子模糊形状,是通过模拟EUV曝光导致的降解(化学变化)而得出的。研究表明,其结果的最佳拟合是通过高斯差(一个s=3.4纳米,另一个(相对权重79.4%)s=2.7纳米)实现的。在将此电子模糊函数与光子吸收曲线卷积后,随后再将s=5纳米的高斯模糊与结果卷积,以表示化学放大抗蚀剂(CAR)情况下的酸曲线。
对于金属氧化物抗蚀剂(MOR)的情况,我们可以参考海外报告中的数据。报告显示,1.6电子伏(eV)的电子可以穿透20纳米厚的SnOH抗蚀剂,然后根据剂量程度从基板反射回来,穿过整个厚度;而1.2电子伏的电子也会发生类似情况,但在电子动能达到陷阱能量时,会被困在距抗蚀剂顶部约11-12纳米处。需要注意的是,如果电子甚至未到达基板,则无法测量抗蚀剂厚度,因为支撑底部部分已被溶解。从指数拟合来看,1.2电子伏电子的衰减长度为1.4纳米,而1.6电子伏电子的衰减长度为3.2纳米。由于所有电子都必须通过1.6电子伏才能达到陷阱能量,因此外部模糊标度参数取两者中较大者(3.2纳米)。内部标度参数(0.448纳米)和相对权重(14%)的选择是为了满足以下两个条件:(1)零距离处概率为零,以及(2)在1纳米处具有峰值概率,与预期分子尺寸匹配。图1展示了经过上述处理后产生的电子模糊函数形状。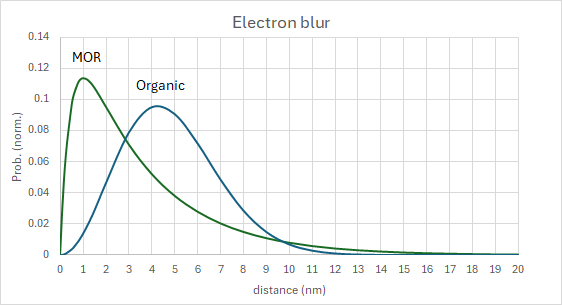
Figure 1. Representative electron blur function shapes for organic and metal oxide resists. Parameters are provided in the text.
EUV光刻胶的代表性电子噪声模型
在过去的研究中,电子噪声被建模为每个光电子(即被吸收光子)5到9个整数范围内的均匀分布。这种模型允许一个电子逃离基于锡(Sn)的金属氧化物抗蚀剂(MOR)层。然而,对于化学放大抗蚀剂(CAR)情况,业界通常会对其进行类似处理,建模为每个吸收光子8到16个整数范围,包括一个逸出电子。有分析指出,可以计算范围[p,q]的最小3s/avg电子噪声,公式为3*sqrt([n^2-1]/12)/m,其中m=(p+q)/2且n=q-p+1。这估算出CAR情况下的噪声约为55%,而MOR情况下的噪声约为61%。
结合EUV随机效应的像素概率
在EUV光刻中,像素缺陷概率的计算通常基于泊松累积分布函数(CDF),并对每个可能的光子电子数进行平均。给定每个光子电子数的泊松分布的CDF通常用伽马函数描述,其本质是exp(-N)*Nj/j!的总和(对于j=0到k,即测试吸收光子或光电子数),其中N是目标或阈值吸收光子或光电子数。对于化学放大抗蚀剂(CAR)情况,酸量子产率(35%)会乘以吸收光子或光电子数。模糊效应通过缩小差异,有效地使给定像素的吸收光子数接近平均值(所有像素的平均值)。这种缩小因子正是前面在吸收光子分布与模糊分布卷积背景下提到的对比度降低因子。
业界针对三种典型的光刻情况对像素缺陷概率进行了估算:
- 氩氟浸没式(ArFi)光刻: 采用40纳米半间距,80纳米厚抗蚀剂(3个单位/微米吸收),2纳米像素,s=5纳米高斯酸模糊。
- EUV化学放大抗蚀剂(CAR): 采用20纳米半间距,40纳米厚抗蚀剂(5个单位/微米吸收),2纳米像素,s=5纳米高斯酸模糊。
- EUV金属氧化物抗蚀剂(MOR): 采用20纳米半间距,40纳米厚抗蚀剂(20个单位/微米吸收),1纳米像素。
EUV CAR和MOR的电子模糊形状已在图1中有所展示。估算结果如图2所示。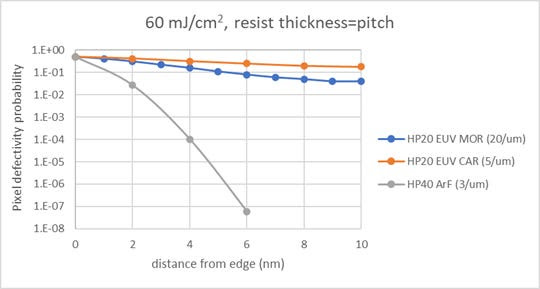
Figure 2. Pixel defectivity probability (failure to reach up to threshold) as a function of distance from half-pitch line edge, for three different resist exposure cases. Resist conditions are provided in the text.
从图2中可以清晰看出,在20纳米曝光半间距内,EUV曝光比ArFi 40纳米半间距的缺陷更多。这解释了为何随机缺陷问题直到EUV光刻出现后才成为一个显著的挑战。理解像素概率有助于计算各种EUV随机效应的概率,但对这些概率的解读需要格外谨慎。
边缘边界像素
首先,需要明确的是,边缘像素的概率通常被认为是50%。由于它代表特征的边缘边界,在评估随机效应的实际概率时,我们可以将其排除在核心考量范围之外。
边缘粗糙度
与边缘边界像素相邻的像素线,可以用于评估边缘粗糙度。对于60毫焦耳/平方厘米(mJ/cm2)的EUV入射剂量,化学放大抗蚀剂(CAR)和金属氧化物抗蚀剂(MOR)两种情况(分别为5个单位/微米和20个单位/微米吸收),每个像素大约有20-30个被吸收光子。两种抗蚀剂的电子噪声贡献也相当,CAR的每个光子平均电子数较大,但被较大的扩散所补偿,与MOR相比。因此,对于两种抗蚀剂,与20纳米半间距边缘边界相邻的像素的像素概率约为30-50%。通过将此概率除以40纳米间距乘以(2乘以像素尺寸)的实际平铺面积,可以找到与边界相邻的单个缺陷像素的密度。换言之,我们可以通过倒数此密度来估算每个缺陷的面积,大约每2个像素/30-50% = 4-6个像素(CAR为8-12纳米,MOR为4-6纳米)出现一个边缘缺陷。这与行业观察到的参差不齐的边缘现象是吻合的。
边缘缺口/突出缺陷
像素概率从边缘处的50%开始,并随着远离边缘向特征内部移动而逐渐降低。因此,由于泊松噪声加上电子噪声而形成缺陷的最可能位置是边缘。由此,一个从线条边缘延伸数纳米并沿线条延伸数纳米的边缘缺陷可以具有较高的缺陷密度,如图3所示。这里用于估算缺陷密度的平铺面积是间距乘以(缺陷长度加上1个像素)。
Figure 3. Edge defect probabilities for three resist cases. Left: 40 nm pitch 20 nm trench EUV MOR, 40 nm thickness, 60 mJ/cm2. Center: 40 nm pitch 20 nm trench EUV CAR, 40 nm thickness, 60 mJ/cm2. Right: 80 nm pitch ArFi CAR targeting 20 nm trench in negative resist, 40 nm thickness, 30 mJ/cm2. s=5 nm Gaussian acid blur was assumed for both EUV and ArFi CAR. TE ArFi polarization and 50% TE/50% TM EUV polarization assumed.
作为参考的氩氟(ArF)情况表明,由于在较厚的抗蚀剂中吸收了更多的光子,缺乏电子噪声,并且在较大间距上模糊影响小得多,其缺陷密度呈指数级降低。此外,化学放大抗蚀剂(CAR,2纳米)比金属氧化物抗蚀剂(MOR,1纳米)更大的像素尺寸也对其不利,因为EUV CAR缺陷的缺陷密度会比MOR小缺陷的缺陷密度更高,如图3所示。
线条断裂缺陷
像素线穿过线条的概率,主要取决于横跨线条的像素数量。这个数量自然与线宽成正比,例如半间距。这导致随着间距的减小,断线概率呈指数级增加,如图4所示。这里用于估算缺陷密度的平铺面积是间距乘以2纳米(即缺陷宽度加上1个像素)。值得注意的是,即使缺陷密度高达2e5/cm2,这相当于524平方微米/缺陷,即无法在一个扫描电子显微镜(SEM)图片中捕获所有缺陷。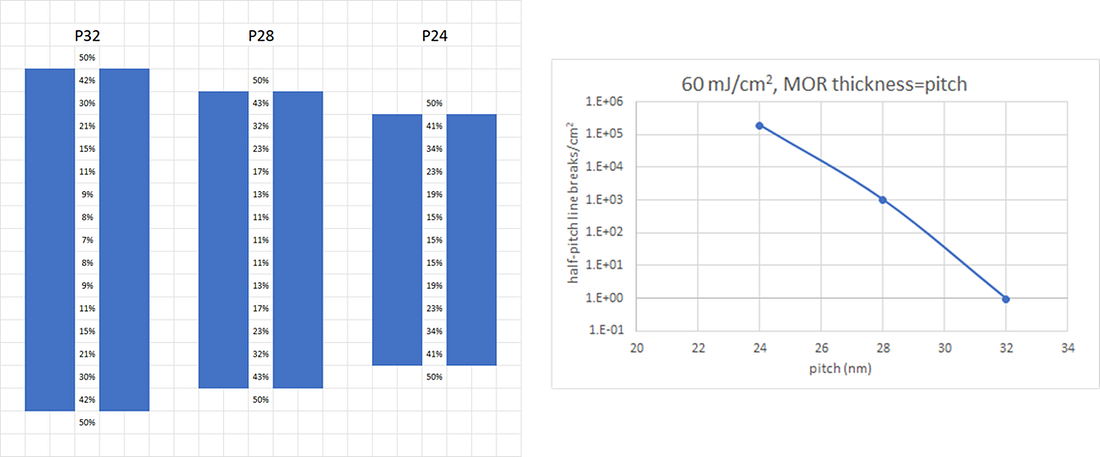
Figure 4. Probabilities for MOR line breaks as a function of pitch. These are occurrences of 1 nm wide strip of resist failing to be exposed above threshold.
当间距减小到20纳米时,更宽的断线可能会导致高缺陷密度。在20纳米厚的MOR中,2纳米宽的断线缺陷密度可达744个/平方厘米。这里,平铺面积为20纳米间距乘以3纳米(即2纳米宽度加上1个像素)。
局部模糊变化
此前有研究提出,模糊效应可能存在局部变化。这种变化也会对缺陷密度产生显著影响。将外部电子模糊标度参数从3.2纳米更改为5纳米,同时保持零距离处的零概率和1纳米处的峰值概率,会导致图3中4纳米×4纳米边缘缺陷的密度从200个/平方厘米急剧增加到超过1e5个/平方厘米!因此,晶圆上的实际缺陷密度取决于晶圆上3.2纳米情况与5纳米情况的相对概率。这对于每种不同的抗蚀剂涂层都可能有所不同,是芯片制造良率管理中需要深入考量的重要因素。
光学技术在光刻中的主导作用已发生转变
随着芯片特征间距的不断缩小,决定实际分辨率限制的主导因素不再仅仅是波长或数值孔径(NA)等传统光学参数,光刻胶模糊、电子噪声和分子尺寸等材料和物理层面的因素其重要性已日益凸显,甚至超越了传统光学参数。除了图像对比度和焦深,缺陷密度已上升为一个不可忽视的关键考量。这正是为什么传统投影光刻方案在某个阶段必须依赖多重图案化等先进技术来突破瓶颈。这种转变不仅意味着半导体设备制造商面临新的研发方向,也给上游材料供应商带来了更高的技术要求。对于全球半导体产业链而言,材料科学与工艺的创新将成为推动EUV光刻技术持续发展的核心驱动力。
新媒网(公号: 新媒网跨境发布),是一个专业的跨境电商、游戏、支付、贸易和广告社区平台,为百万跨境人传递最新的海外淘金精准资讯情报。
本文来源:新媒网 https://nmedialink.com/posts/euv-5nm-blur-500x-defects-yield-at-risk.html


 粤公网安备 44011302004783号
粤公网安备 44011302004783号 










